外延生长设备
这是为实现高质量外延所需的
高效率和节能型单晶片式高速外延生长设备。
特点
核心技术
基于成膜技术的原理
通过垂直方向气流与高速晶片旋转的组合,在晶片上形成极薄的均匀浓度分界层(※)。
薄的浓度分界层易于吸收原料气体,而且利用离心力易于排出副产物HCl气体。
最终使下述反应易于朝右进行,原料气体的利用效率高达20~30%,能够进行高速生长。
- 1. 通过SiHCl3 → SiCl2* ↓ + HCl ↑ 热分解,产生的SiCl2* 吸附在基板表面
- 2. 在SiCl2* + H2 → Si ↓ + 2HCl ↑ 基板表面,Si单晶硅生长
- (※) 浓度分界层是指晶片面上发生成膜反应的厚度层区域。
晶片高速旋转的优点
随着转速的增加生长速度加快
随着转速的增加,原料气体利用效率提高,达到外延膜的生长速度提高的结果。

(来源)我们公司(HT2000FD)
使晶片高速旋转,炉内的原料气体的输送效率增大,可提高晶片表面的原料气体浓度。
因此,不用增加原料气体的使用量,就能提高生长速度。
设备规格(HT2000FD)
| 晶片尺寸 | 200mmφ |
|---|---|
| 加热方式 | 背面电阻固体加热 |
| 加热过程温度 | 800~1,150℃ |
| 晶片转速 | 300~900rpm |
| 压力 | 93(700)~13.3(100)kPa(Torr) |
| 使用气体种类 | SiHCl3, SiH2Cl2, H2, HCl |
| 外形尺寸 | (本体 1,396mm(W)×2,276mm(D)×2,350mm(H)) |
| 设备重量 | (本体 约2,300Kg) |
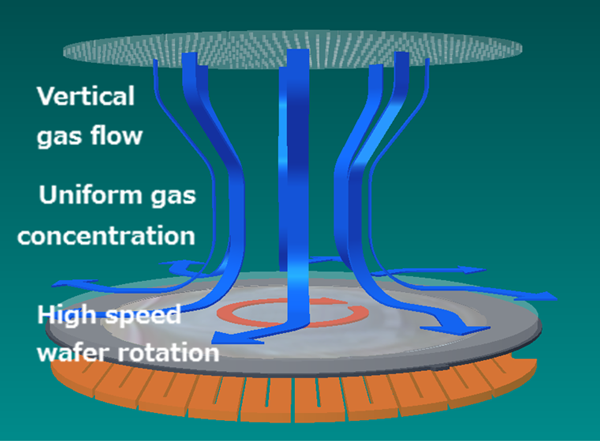
研发路线图
外延生长设备是以气控技术为核心技术、在硅晶圆上让硅单结晶生长的设备。本公司进一步发展Si外延生长设备 “HT2000FD” 的高速旋转技术、向市场推出了GaN on Si外延生长设备 “EPIREVO™ G8”、SiC外延生长设备 “EPIREVO™ S6” 和 “EPIREVO™ S8”※我们已经停止生产 “HT2000FD”(仅提供维护服务)。



